Сравнение SOI и кремниевых пластин: Что лучше для вашего полупроводникового проекта?
1 Введение
SOI - это полупроводниковый материал со слоистой структурой кремниевый слой-изолирующий слой-кремниевая подложка. По сравнению с кремниевыми пластинами, которые широко используются в полупроводниковых приборах, между ними существуют значительные различия в структуре материала, эксплуатационных характеристиках, областях применения и т.д.
Структура SOI повышает производительность и надежность устройства за счет многослойной структуры кремниевый слой-изолирующий слой-кремниевая подложка, но при этом стоимость производства выше. Традиционные кремниевые пластины, с другой стороны, имеют более низкую стоимость изготовления и подходят для широкого спектра производства интегральных схем.
![]()
2 Что такое SOI?
SOI расшифровывается как Silicon-On-Insulator. В SOI поверхность кремниевого чипа покрывается изолирующим материалом (обычно диоксидом кремния), на котором затем выращивается слой кремния. Таким образом, создается слоистая структура "слой кремния - изолирующий слой - кремниевая подложка".
2.1 Структура SOI
Структура SOI (Silicon-On-Insulator) состоит из следующих основных частей:
- Слой Si: Поверх структуры SOI находится слой кристаллов кремния (Si), которые обычно обладают необходимыми электронными свойствами и характеристиками устройства. Этот слой может быть подготовлен с использованием стандартных технологий выращивания кремниевых пластин.
- Изолирующий слой: Под слоем Si находится изолирующий материал, обычно диоксид кремния (SiO2). Цель изолирующего слоя - изолировать кремниевый слой сверху от кремниевой подложки снизу, тем самым уменьшая перекрестные помехи между транзисторами.
- Кремниевая подложка: Кремниевая подложка является нижней частью структуры SOI и, как правило, основной опорной подложкой для пластины. Кремниевая подложка обычно представляет собой кристаллический кремний, который обеспечивает механическую поддержку и стабильность структуры SOI.
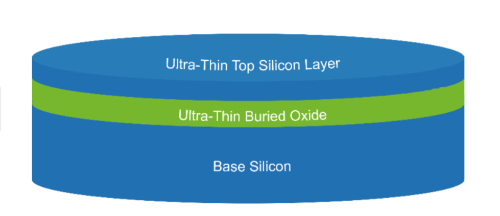
2.2 Классификация SOI
Существует несколько различных вариантов технологии SOI. SOI можно классифицировать по различным критериям, в зависимости от их структуры и назначения.
2.2.1 Классификация по типу структуры
Общий SOI (c-SOI): Общая SOI - одна из наиболее распространенных структур SOI, также известная как полная SOI. В ней используется распространенный метод изготовления SOI, при котором на поверхность кремниевой пластины наносится изолирующий слой (обычно диоксид кремния), а затем поверх него выращивается слой кремния. В обычном SOI толщина кремниевого слоя обычно сопоставима с толщиной изолирующего слоя, образуя структуру "кремниевый слой - изолирующий слой - кремниевая подложка".
Частичный SOI (p-SOI): Частичный SOI отличается от обычного SOI тем, что толщина кремниевого слоя меньше, лишь на часть толщины изолирующего слоя. В частичной SOI толщина кремниевого слоя обычно меньше толщины изолирующего слоя, что дает структуре частичной SOI более тонкий кремниевый слой.
Обратный SOI (r-SOI): Обратный SOI - это особая структура SOI, которая отличается от обычного SOI и частичного SOI. В обратной SOI слой кремния удаляется с подложки и снова прикрепляется к изолирующему слою. Такая структура позволяет транзистору располагаться над изолирующим слоем, а кремниевой подложке - под изолирующим слоем, что изменяет топологию обычной SOI-структуры.
Эти различные варианты SOI обладают разными преимуществами и применимы в конкретных областях. Обычные SOI обычно используются в высокопроизводительных и маломощных приложениях, частичные SOI больше подходят для изготовления некоторых специфических радиочастотных (RF) устройств, а инвертированные SOI дают дополнительные преимущества в специфических приложениях, таких как высокоскоростные устройства с низкими потерями.
2.2.2 Классификация по типу кристаллической подложки
Кремний-на-Изоляторе (SIMOX-SOI): SIMOX (Separation by IMplantation of OXygen) - распространенный метод получения SOI, также известный как кремний-на-изоляторе. При подготовке SIMOX-SOI ионы кислорода вводятся в пластину, а затем подвергаются термической обработке, в результате чего ионы кислорода образуют изолирующий слой оксида кремния в пластине, что приводит к формированию структуры SOI.
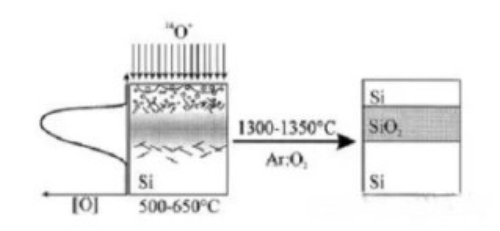
Ультратонкий SOI (UTSOI): Ultra-Thin SOI - это особый тип SOI-структуры, характеризующийся очень тонким слоем кремния, обычно от нескольких нанометров до десятков нанометров. Метод получения UTSOI обычно включает в себя специальные технологии роста или зачистки для формирования очень тонкого слоя кремния на кремниевой подложке для реализации структуры SOI.
Эпитаксиальный SOI (Epi-SOI): Epi-SOI - это метод формирования SOI-структур путем выращивания эпитаксиального слоя кремния на кремниевой подложке. В Epi-SOI эпитаксиальный слой кремния выращивается на кремниевой подложке и, как правило, имеет ту же кристаллическую структуру, что и подложка, но между слоем кремния и подложкой имеется изолирующий слой.
SIMOX-SOI обычно используется при производстве ИС, UTSOI - для высокопроизводительных и маломощных приложений, таких как мобильная связь и радиочастотные устройства, а Epi-SOI обеспечивает лучшее качество кристаллов и структурный контроль для конкретных нужд производства устройств.
2.2.3 Классификация по толщине слоя кремния
Тонкопленочный SOI: В тонкопленочном SOI толщина слоя кремния обычно составляет от десятков нанометров до сотен нанометров. Этот тип SOI-структуры часто используется для изготовления ультратонких устройств, таких как электронные устройства с низким энергопотреблением, оптоэлектронные устройства и т.д. Тонкослойные SOI обычно получают с помощью серии прецизионных этапов обработки, включая такие методы, как химико-механическая полировка (CMP), инжекция ионов водорода и зачистка.
Толстопленочные SOI: В толстопленочных SOI толщина слоя кремния обычно составляет несколько сотен нанометров и более. Этот тип SOI-структуры обычно используется для изготовления традиционных устройств интегральных схем, таких как микропроцессоры, память и т. д. Толстослойные SOI обычно получают с помощью различных технологий, таких как SIMOX, Unibond и Smart Cut. Эти технологии позволяют получать слои кремния большой толщины, что отвечает потребностям традиционного производства интегральных схем.
2.2.4 Классификация по методу управления зарядом для транзисторов
Полностью обедненный SOI (FD-SOI): В FD-SOI весь кремниевый слой находится в обедненном состоянии, что означает, что заряд транзистора полностью контролируется затвором, расположенным выше, и не зависит от нижней подложки. Точно контролируя толщину слоя кремния и характеристики изолирующего слоя, можно добиться того, чтобы весь слой кремния находился в обедненном состоянии. Такая структура обеспечивает лучший контроль заряда и меньший ток утечки. Полностью обедненный SOI часто рассматривается как полупроводниковая технология нового поколения с более высокой производительностью и низким энергопотреблением, поэтому ей уделяется все больше внимания при разработке и изготовлении микросхем.
Частично обедненный SOI (pFD-SOI): В частично обедненном SOI часть кремниевого слоя находится в обедненном состоянии, а другая часть остается в не обедненном состоянии. Как правило, при правильном проектировании и технологическом процессе можно добиться того, чтобы только часть кремниевого слоя (обычно верхняя часть) находилась в обедненном состоянии. Частично обедненный SOI может использоваться в высокопроизводительных и маломощных приложениях, таких как мобильная связь, радиочастотные (RF) устройства и другие области. Это открывает возможности для лучшего контроля заряда и оптимизации производительности.

В таблице ниже представлены различные структуры SOI, их определяющие характеристики и типичные области применения, что дает полное представление о различиях между каждым типом SOI.
Stanford Advanced Materials (SAM) и другие надежные поставщики предлагают пластины SOI различных размеров и типов. Эти варианты могут быть подобраны в соответствии с вашими точными спецификациями.
Таблица 1 Сравнение различных типов пластин SOI
|
Классификация |
Тип |
Краткое описание и области применения |
|
Тип структуры |
c-SOI |
Толщина слоя кремния аналогична толщине изолирующего слоя. Используется в высокопроизводительных и маломощных приложениях. |
|
p-SOI |
Более тонкий кремниевый слой по сравнению с изолирующим слоем. Подходит для изготовления специфических радиочастотных устройств. |
|
|
r-SOI |
Слой кремния прикреплен поверх изолирующего слоя, инвертируя структуру. Для высокоскоростных устройств с низкими потерями. |
|
|
Тип кристаллической подложки |
SIMOX-SOI |
Ионы кислорода образуют изолирующий слой оксида кремния. Распространена при изготовлении интегральных схем. |
|
UTSOI |
Сверхтонкий кремниевый слой для высокопроизводительных и маломощных приложений, таких как мобильные и радиочастотные устройства. |
|
|
Epi-SOI |
Эпитаксиальный слой, выращенный на кремниевой подложке, для устройств, требующих лучшего качества кристаллов. |
|
|
Толщина слоя кремния |
Тонкопленочный SOI |
Слой кремния толщиной от десятков до сотен нанометров. Для маломощных электронных и оптоэлектронных устройств. |
|
Толстопленочный SOI |
Кремниевый слой толщиной в несколько сотен нанометров. Используется в традиционных ИС, таких как микропроцессоры. |
|
|
Метод управления зарядом для транзисторов |
FD-SOI |
Весь кремниевый слой истощен для полного контроля заряда. Нацелен на высокопроизводительные и маломощные технологии нового поколения. |
|
pFD-SOI |
Частичное истощение слоя кремния. Применяются в высокопроизводительных и маломощных приложениях (например, в мобильных устройствах, радиочастотах). |
3 SOI против кремниевых пластин, что лучше?
Технология "кремний-на-изоляторе" (SOI) и традиционные кремниевые пластины уже давно играют ключевую роль в формировании ландшафта производства полупроводников. Каждая из них обладает различными структурными характеристиками и эксплуатационными возможностями. По мере роста спроса на более эффективные, быстрые и компактные электронные устройства понимание различий между этими двумя основополагающими материалами приобретает решающее значение. Данное сравнение призвано выявить структурные нюансы и результаты работы SOI и кремниевых пластин.
3.1 Различия в структуре SOI и кремниевых пластин
Кремниевая пластина: Традиционная кремниевая пластина состоит из монокристалла кремния и монокристаллической кремниевой структуры. В традиционных кремниевых пластинах поверхность пластины обычно представляет собой монокристалл кремния без дополнительного изолирующего слоя. Кремниевые пластины имеют простую структуру и являются наиболее распространенной подложкой для полупроводниковых приборов.
SOI: в структуре SOI поверхность кремниевой пластины покрыта слоем изолирующего материала (обычно диоксида кремния). Этот слой изоляционного материала обычно используется для изоляции кремниевого слоя от кремниевой подложки, что позволяет уменьшить перекрестные помехи между устройствами и повысить их производительность и надежность. Поверх изолирующего слоя выращивается еще один слой кремния, образуя слоистую структуру кремниевый слой-изолирующий слой-кремниевая подложка. Кремниевый слой является активным слоем транзистора и обычно обладает желаемыми электронными свойствами и характеристиками устройства. Толщина изолирующего слоя может быть изменена в соответствии с требованиями приложения для управления характеристиками и производительностью устройства.
SOI имеют дополнительный изолирующий слой по сравнению с обычными кремниевыми пластинами. Наличие этого изолирующего слоя повышает производительность и надежность устройства, но также увеличивает сложность и стоимость изготовления.
3.2 Различия в характеристиках SOI и кремниевых пластин
- Подавление перекрестных помех: Каждый транзистор в структуре SOI изолирован изолирующим слоем, что значительно снижает перекрестные наводки между устройствами. Благодаря наличию изолирующего слоя снижается эффект электромагнитной связи между транзисторами, что повышает производительность и надежность устройства. Перекрестные помехи обычно являются серьезной проблемой в интегральных схемах высокой плотности, а использование SOI эффективно снижает влияние перекрестных помех на производительность устройства.
- Преимущества в скорости и энергопотреблении: SOI-устройства обычно имеют более высокую скорость и более низкую энергоэффективность. Благодаря сниженному сопротивлению движению заряда в структуре SOI электроны в слое кремния могут двигаться быстрее, что приводит к увеличению скорости переключения и снижению энергопотребления. Это дает SOI явное преимущество в высокопроизводительных и маломощных приложениях, таких как мобильная связь и высокопроизводительные вычисления.
- Улучшенная радиационная стойкость: Структура SOI повышает радиационную стойкость устройства, что делает его более подходящим для применения в условиях повышенного излучения. Благодаря наличию изолирующего слоя устройства SOI менее чувствительны к радиации и поэтому находят широкое применение в космосе, на атомных электростанциях и в других электронных устройствах, работающих в условиях повышенной радиации. Повышенная радиационная стойкость имеет решающее значение для некоторых специфических применений, таких как космическая аэрокосмическая промышленность и ядерная энергетика.
3.3 Как используются SOI и кремниевые пластины
--Области применения SOI
Высокопроизводительные приложения: SOI часто используется в приложениях, требующих высокой производительности, таких как высокоскоростные компьютерные чипы и графические процессоры. Благодаря низкому сопротивлению движению заряда и характеристикам подавления перекрестных помех он идеально подходит для реализации высокой производительности.

Приложения с низким энергопотреблением: Поскольку устройства SOI имеют более низкое энергопотребление и более высокую скорость переключения, они находят широкое применение в таких областях, как мобильные устройства и беспроводные сенсорные сети, где требуется низкое энергопотребление. Например, микросхемы в таких устройствах, как смартфоны и планшетные ПК, часто используют технологию SOI.
Радиочастотные (RF) приложения: Высокая скорость и низкий уровень потерь дают SOI огромное преимущество в радиочастотных (RF) приложениях. Например, устройства SOI могут использоваться для изготовления высокопроизводительных фронтальных модулей РЧ, антенных переключателей, усилителей мощности и т. д.
Применение в средах с высоким уровнем излучения: Структура SOI повышает радиационную стойкость устройства, что делает его важным для применения в космосе, на атомных электростанциях и в других высокорадиационных средах. Например, в космических зондах, системах спутниковой связи и других устройствах, которым необходимо работать в условиях повышенного излучения, часто используется технология SOI.
--Традиционные применения кремниевых пластин
Традиционные кремниевые пластины широко используются при производстве различных интегральных схем, в том числе микропроцессоров, памяти, датчиков и т. д. Кремниевые пластины являются основой для производства интегральных схем (ИС). Различные типы ИС, включая микропроцессоры, память, аналоговые схемы, цифровые схемы и т. д., производятся путем наслоения различных материалов и схем на кремниевых пластинах. Почти во всех электронных устройствах, таких как персональные компьютеры, бытовая техника и автомобильные электронные системы, используются традиционные микросхемы, изготовленные на кремниевых пластинах. Они также могут использоваться для производства различных электронных устройств, широко применяемых в промышленности, солнечных батарей и биомедицинских приборов. Благодаря отличным полупроводниковым свойствам, а также отработанным производственным процессам и стабильному контролю качества, кремниевые пластины широко используются в производственных и исследовательских процессах, а технологический порог также ниже по сравнению с SOI.
3.4 Как производятся SOI и кремниевые пластины
--Методы подготовки кристаллов SOI
3.4.1 Технология SIMOX
Технология SIMOX, сокращение от Separation by IMplantation of OXygen, является одним из передовых методов подготовки пластин SOI (Silicon-On-Insulator). Эта технология использует ионную имплантацию для внедрения ионов кислорода в кремний, формируя изолирующий слой оксида. Этот погребенный оксидный слой эффективно изолирует подложку от верхнего слоя тонкой пленки кремния. Процесс включает в себя инжекцию ионов кислорода в кремниевую пластину под поверхностью, как правило, при энергии 200 кэВ и дозе 1,8 × 10^18 см^-2. Затем высокотемпературный отжиг в течение 3-6 часов при температуре 1350°C способствует химическим реакциям между ионами кислорода и атомами кремния внутри пластины, в результате чего под поверхностью образуется изолирующий слой диоксида кремния толщиной менее 240 нм. Над этим изолирующим слоем формируется слой кристаллического кремния, в результате чего образуется структура SOI, состоящая из тонкой пленки кремния - изолирующего слоя диоксида кремния - кремниевой подложки.
К преимуществам технологии SIMOX относится формирование относительно однородного слоя Buried Oxide (BOX). Толщину слоя кремния в BOX можно точно контролировать, управляя энергией инжекции. Кроме того, граница раздела между BOX и верхним слоем кремния остается очень плоской.
Однако технология SIMOX имеет свои ограничения. Диапазон регулировки толщины BOX и верхнего кремниевого слоя относительно ограничен. Обычно толщина BOX не превышает 240 нм, поскольку слишком тонкие слои могут привести к пробою между верхним слоем и подложкой, что сопровождается увеличением паразитной емкости. Аналогично, толщина верхней кремниевой пленки обычно ограничена 300 нм, что требует дорогостоящего эпитаксиального выращивания кремния и последующей химико-механической полировки (ХМП) сплющивающей обработки. Кроме того, SIMOX может вызвать повреждение поверхностной пленки, а кристаллическое качество верхней кремниевой пленки может не соответствовать качеству объемного монокристаллического кремния. Более того, качество кристаллов захороненного SiO2 уступает качеству, достигаемому при термическом окислении. Для реализации SIMOX требуется специализированное оборудование для ионной имплантации, например, дорогостоящие установки для нагнетания кислорода в большом пучке, а также длительные высокотемпературные процессы отжига, что приводит к увеличению производственных затрат.
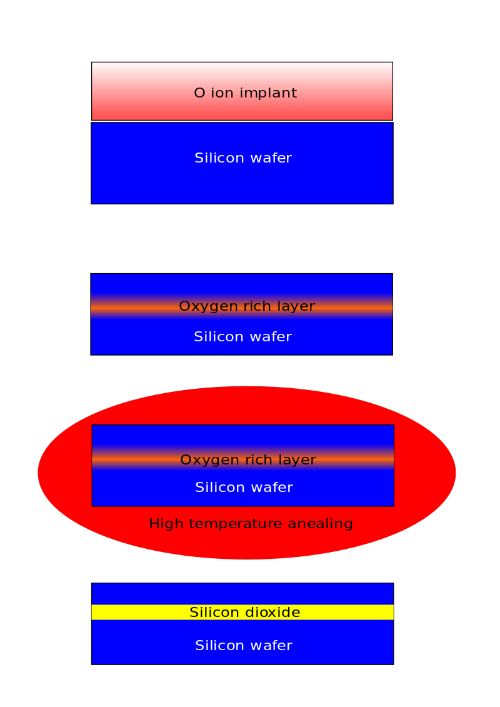
3.4.2 Технология BESOI
Технология BESOI (Bond and Etch Back Silicon-On-Insulator) предполагает склеивание двух пластин вплотную друг к другу, создавая между ними слой диоксида кремния в качестве погребенного оксидного слоя. Затем используется технология обратной гравировки для точной подгонки толщины одной пластины, чтобы сформировать пластины SOI нужной толщины.
Процесс BESOI начинается с обработки одной пластины (пластины A) термическим окислением, в результате чего образуется оксидный слой, а другая пластина (пластина B) подвергается низкотемпературному соединению с оксидированной поверхностью пластины A. Этот процесс соединения, известный как Silicon Fusion Bonding (SFB), включает несколько этапов:
Гидрофильная обработка: Обе пластины подвергаются низкотемпературной (400°C) гидрофильной обработке, чтобы вызвать образование гидроксильных (OH) связей на их поверхностях.
Связывание с помощью сил Ван-дер-Ваальса: Затем две пластины приводятся в контакт, и OH-связи способствуют их соединению за счет силы Ван-дер-Ваальса.
Термический отжиг: Высокотемпературный (1100°C) термический отжиг проводится для отгона ионов водорода, способствуя образованию связей Si-O-Si на границе раздела, тем самым усиливая сцепление.
Обратное травление: излишки кремния с одной пластины удаляются с помощью технологии обратной гравировки, оставляя желаемую толщину верхней тонкой пленки кремния. Последующий отжиг и химико-механическая полировка (CMP) обеспечивают формирование гладкой и чистой поверхности для пластин SOI.
Технология BESOI обладает рядом преимуществ по сравнению с технологией SIMOX. Например, она позволяет избежать проблем, связанных с инжекционными повреждениями, и обеспечивает формирование термически окисленного погребенного оксидного слоя с меньшей плотностью дефектов и пинхоллов. Кроме того, верхняя кремниевая пленка, полученная по технологии BESOI, состоит из высококачественного монокристаллического кремния, что повышает общую производительность устройства.
Однако технология BESOI также сопряжена с определенными трудностями. Трудно добиться очень тонких верхних кремниевых пленок, а контроль дефектов интерфейса и однородности верхней кремниевой пленки остается сложной задачей. Кроме того, процесс включает в себя дорогостоящие этапы обратной гравировки и CMP, что приводит к значительным отходам материала подложки, который не может быть переработан и приводит к увеличению производственных затрат.
3.4.3 Технология Smart-Cut
Технология Smart-Cut заимствована из BESOI: сначала готовятся две кремниевые пластины; одна из пластин термически окисляется для формирования слоя SiO2, а затем в подложку пластины вводятся ионы водорода; вторая пластина не требует обработки; как и в случае BESOI, две пластины склеиваются вместе; После склеивания пластины, в которые впрыскиваются ионы водорода, разрушаются на границе раздела, обогащенной ионами водорода, в результате термической реакции при 400-600 °C; наконец, на границе раздела между разрушенной поверхностью и оксидным слоем образуется слой кремниевой пленки после высокотемпературной обработки (1100 °C) для отгона ионов водорода. После склеивания пластины, в которые вводятся ионы водорода, разрушаются в точке обогащения ионами водорода, и между поверхностью разрушения и оксидным слоем образуется слой тонкой пленки кремния; наконец, после высокотемпературной обработки (1100 °C) ионы водорода изгоняются, так что на поверхности склеивания образуется связь Si-O-Si, которая укрепляет химическую связь и улучшает качество слоя тонкой пленки кремния, а затем поверхность выравнивается с помощью обработки CMP.
Технология Smart-Cut похожа на BESOI тем, что верхняя кремниевая пленка представляет собой объемный кремний, а BOX - термически окисленную пленку. Толщина слоя BOX и верхней кремниевой пленки может регулироваться в широком диапазоне, а толщина верхней кремниевой пленки контролируется за счет использования энергии ионной имплантации, так что можно получить верхнюю кремниевую пленку с очень малой толщиной и хорошей однородностью. Кроме того, материал снятой пластины может быть использован повторно, что позволяет снизить затраты.

--Метод подготовки кристаллов кремниевых пластин
Для выращивания кристаллов кремния широко используется метод Чохральского, при котором тигель, заполненный кремнием, нагревается до температуры 1685°C. Эта температура превышает температуру плавления кремния. Эта температура превышает температуру плавления кремния примерно на 100°C, в результате чего кремний в тигле становится расплавленным. В верхней части тигля находится подъемный стержень, оснащенный механическим устройством, позволяющим ему свободно подниматься и вращаться. На рычаге закреплен небольшой кусочек монокристаллического кремния, выполняющий роль "затравки". Этот затравочный кристалл инициирует притяжение окружающих атомов кремния, организуя их в кристаллическую структуру. По мере того как кристалл постепенно поднимается и вращается, извлеченные секции остаются частью одного и того же монокристалла. Полученный в результате большой монокристалл достигает 200 миллиметров в диаметре, что толще средней руки. В этом кристалле нет ни граней, ни дефектов, что свидетельствует о высочайшем совершенстве, достижимом в монокристаллах, созданных человеком.
Чтобы обеспечить чистоту материала и предотвратить неравномерное зарождение, все операции должны проводиться в вакууме или под защитой инертного газа. Традиционные технологии выращивания монокристаллического кремния предполагают создание тонкой шейки в начале роста кристалла, так называемый "метод шейки", для предотвращения дислокаций в кристалле. Однако прогресс в технологии засева, в частности введение значительного количества бора в затравочный кристалл, значительно повысил его прочность, избавив от необходимости делать шейку диаметром 3 мм. Этот инновационный подход заменяет метод высева, применявшийся в течение трех десятилетий, и не только облегчает производство крупного монокристаллического кремния, но и сокращает время роста кристаллов и повышает выход продукции, открывая тем самым возможности для экономически эффективного производства сверхкрупных интегральных схем.
При выращивании пластин поликремний вводится в кварцевый тигель в печи, после чего производится продувка вакуумом или инертным газом для создания расплавленного состояния. Как только расплавленный кремний стабилизируется, монокристаллы можно вытягивать, используя внутреннее направление кристаллов заранее определенного затравочного кристалла в качестве направляющей на поверхности жидкости. Благодаря точному контролю высоты жидкой поверхности тигля, температуры границы раздела твердое тело-жидкость и скорости вращения затравочного кристалла кремний превращается из жидкого состояния обратно в твердое, обеспечивая равномерное внутреннее направление кристаллов для выращивания монокристаллов большого диаметра. Управляемые компьютером процессы автоматической регулировки и скорости подъема гарантируют изотропный рост монокристаллического кремния.
Таблица 2 Сравнение пластин SOI и кремниевых пластин
|
Кремниевая пластина |
Пластина SOI |
||
|
Структура |
Без изолирующего слоя |
Изолирующий слой |
|
|
Производительность |
Подавление перекрестных помех |
Нет |
Да |
|
Скорость и мощность |
Ниже и выше |
Выше и ниже |
|
|
Радиационная стойкость |
Ниже |
Выше |
|
|
Области применения |
Интегральные схемы |
Высокопроизводительные приложения |
|
|
Солнечные элементы |
Маломощные приложения |
||
|
Биомедицинские устройства |
Среды с высоким излучением |
||
|
Подготовка и стоимость |
Метод Чохральского |
SIMOX/BESOI/Smart-cut |
|
|
Удобно |
Замысловатые |
||
|
Низкая стоимость |
Высокая стоимость |
||
4 Заключение
Существуют значительные различия между SOI и кремниевыми пластинами с точки зрения структуры материала, эксплуатационных характеристик, областей применения и т. д. Структура SOI повышает производительность и надежность устройств за счет многослойной структуры кремниевый слой-изолирующий слой-кремниевая подложка, но при этом требует больших затрат на производство. В отличие от этого, традиционное производство кремниевых пластин является менее дорогостоящим и подходит для широкого спектра производства интегральных схем. Поэтому при выборе структуры материала следует всесторонне оценить преимущества и недостатки SOI и кремниевых пластин, исходя из конкретных требований к применению и соображений стоимости, чтобы добиться наилучшей производительности и экономической выгоды.
Связанное чтение:
Влияние качества кремниевых пластин на производительность и надежность полупроводников
Ссылки:
[1]Jin W, Wei C, Wanghua Z, et al. Оптимизация и всестороннее сравнение термооптического фазовращателя со складчатым волноводом на платформах SiN и SOI[J]. Optics Communications, 2024, 555.
[2]Xin F, Jiaqi N, Shanglin Y, et al. Оптические режекторные фильтры с перестраиваемой центральной длиной волны и реконфигурируемым свободным спектральным диапазоном на платформе SOI[J]. Optics Communications, 2024, 554.
[3]N. V ,A. M , I. K , et al. Novel crossbar array of silicon nitride resistive memories on SOI enables memristor rationed logic[J]. Solid State Electronics, 2024, 211.

 Бары
Бары
 Бисер и шары
Бисер и шары
 Болты и гайки
Болты и гайки
 Кристаллы
Кристаллы
 Диски
Диски
 Волокна и ткани
Волокна и ткани
 Фильмы
Фильмы
 Хлопья
Хлопья
 Пены
Пены
 Фольга
Фольга
 Гранулы
Гранулы
 Медовые соты
Медовые соты
 Чернила
Чернила
 Ламинат
Ламинат
 Шишки
Шишки
 Сетки
Сетки
 Металлизированная пленка
Металлизированная пленка
 Тарелка
Тарелка
 Порошки
Порошки
 Род
Род
 Простыни
Простыни
 Одиночные кристаллы
Одиночные кристаллы
 Мишень для напыления
Мишень для напыления
 Трубки
Трубки
 Стиральная машина
Стиральная машина
 Провода
Провода
 Конвертеры и калькуляторы
Конвертеры и калькуляторы




 Chin Trento
Chin Trento



